QR код

Продукти
Свържете се с нас


факс
+86-579-87223657

Електронна поща

Адрес
Wangda Road, Ziyang Street, Wuyi County, Jinhua City, Zhejiang Province, Китай
В полупроводници и дисплеи на FPD панела подготовката на тънки филми е важен процес. Има много начини за приготвяне на тънки филми (TF, тънък филм), следните два метода са често срещани:
● CVD (отлагане на химически пари)
● PVD (физическо отлагане на пари)
Сред тях буферният слой/активен слой/изолационен слой се отлага в камерата на машината с помощта на PECVD.
● Използвайте специални газове: SiH4/NH3/N2O за отлагане на SiN и Si/SiO2 филми.
● Някои CVD машини трябва да използват H2 за хидрогениране, за да се увеличи мобилността на носителя.
● NF3 е почистващ газ. За сравнение: F2 е силно токсичен и парниковият ефект на SF6 е по-висок от този на NF3.
В процеса на полупроводникови устройства има повече видове тънки филми, в допълнение към обикновените SiO2/Si/SiN, има и W, Ti/TiN, HfO2, SiC и др.
Това е и причината да има много видове предшественици за напреднали материали, използвани в полупроводниковата индустрия, за да се направят различни видове тънки филми.
1. Видове CVD и някои предшественици газове
2. Основен механизъм на CVD и качеството на филма
CVD е много обща концепция и може да бъде разделен на много видове. Общите са:
● Pecvd: Плазмен засилен CVD
● LPCVD: CVD с ниско налягане
● ALD: отлагане на атомен слой
● Mocvd: Металоорганични CVD
По време на процеса на CVD химичните връзки на предшественика трябва да бъдат нарушени преди химичните реакции.
Енергията за разбиване на химически връзки идва от топлина, така че температурата на камерата ще бъде сравнително висока, което не е приятелски настроени към някои процеси, като стъклото на субстрата на панела или PI материала на гъвкавия екран. Следователно, чрез въвеждане на друга енергия (формиране на плазма и др.) За намаляване на температурата на процеса, за да се изпълнят някои процеси, които изискват температура, топлинният бюджет също ще бъде намален.
Следователно PECVD отлагането на a-Si:H/SiN/poly-Si се използва широко в индустрията на FPD дисплеите. Често срещани прекурсори и филми на CVD:
Поликристален силиций/монокристален силиций SiO2 SiN/SiON W/Ti WSi2 HfO2/SiC
Етапи на основния механизъм на ССЗ:
1. Реакционният прекурсор газ влиза в камерата
2. Междинни продукти, произведени чрез газова реакция
3. Междинните продукти на газа дифундират към повърхността на субстрата
4. Адсорбиран върху повърхността на субстрата и разпръснат
5. Протича химическа реакция на повърхността на субстрата, образуване на ядра/образуване на остров/образуване на филм
6. Страничните продукти се десорбират, вакуум се изпомпват и изхвърлят след влизане в скрубер за лечение
Както бе споменато по-рано, целият процес включва множество стъпки като дифузия/адсорбция/реакция. Общата скорост на образуване на филм се влияе от много фактори, като температура/налягане/вид на реакционния газ/тип на субстрата. Дифузията има дифузионен модел за прогнозиране, адсорбцията има теория на адсорбцията, а химическата реакция има теория на кинетиката на реакцията.
В целия процес най -бавната стъпка определя цялата скорост на реакция. Това е много подобно на метода на критичния път за управление на проекти. Най -дългият поток на активност определя най -кратката продължителност на проекта. Продължителността може да бъде съкратена чрез разпределяне на ресурси за намаляване на времето на този път. По подобен начин CVD може да намери ключовото препятствие, което ограничава скоростта на формиране на филма, като разбере целия процес и коригира настройките на параметрите, за да постигне идеалната скорост на образуване на филми.
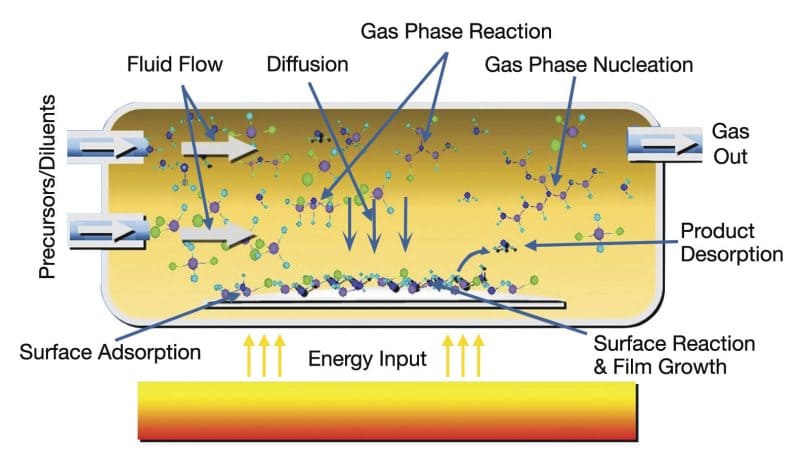
Някои филми са плоски, други запълват дупки, а други запълват жлебове, с много различни функции. Търговските CVD машини трябва да отговарят на основните изисквания:
● Капацитет на машинна обработка, скорост на отлагане
● Консистенция
● Реакциите на газовата фаза не могат да произвеждат частици. Много е важно да не се произвеждат частици в газовата фаза.
Някои други изисквания за оценка са както следва:
● Добро покритие на стъпката
● Възможност за запълване на пропуски в съотношението на високо съотношение (конформация)
● Добра еднообразност на дебелината
● Висока чистота и плътност
● Висока степен на структурно съвършенство с ниско напрежение на филма
● Добри електрически свойства
● Отлична адхезия към материала на основата



+86-579-87223657


Wangda Road, Ziyang Street, Wuyi County, Jinhua City, Zhejiang Province, Китай
Авторско право © 2024 WuYi TianYao Advanced Material Tech.Co., Ltd. Всички права запазени.
Links | Sitemap | RSS | XML | Политика за поверителност |
