QR код

Продукти
Свържете се с нас


факс
+86-579-87223657

Електронна поща

Адрес
Wangda Road, Ziyang Street, Wuyi County, Jinhua City, Zhejiang Province, Китай
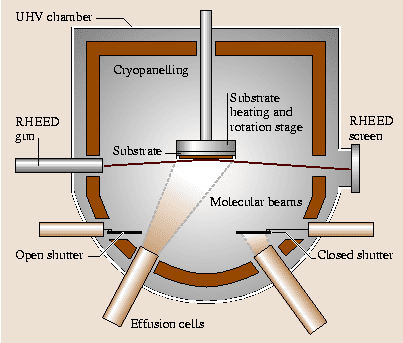
Епитаксиалната пещ е устройство, използвано за производство на полупроводникови материали. Неговият принцип на работа е да отлага полупроводникови материали върху субстрат при висока температура и високо налягане.
Силиконов епитаксиален растеж е да се отглежда слой от кристал с добра целостта на структурата на решетката върху силиконов единичен кристален субстрат с определена ориентация на кристала и съпротивление на същата кристална ориентация като субстрата и различната дебелина.
● Епитаксиален растеж на епитаксиален слой с висока (ниска) резистентност върху ниско (високо) устойчив субстрат
● Епитаксиален растеж на епитаксиален слой от N (P) на P (n) тип субстрат
● В комбинация с технологията на маска, епитаксиалният растеж се извършва в определена област
● Типът и концентрацията на допинг могат да бъдат променени според нуждите по време на епитаксиален растеж
● Растеж на хетерогенни, многослойни, многокомпонентни съединения с променливи компоненти и ултратънки слоеве
● Постигнете контрол на дебелината на размера на атомно ниво
● Отглеждайте материали, които не могат да бъдат издърпани в единични кристали
Полупроводниковите дискретни компоненти и процесите на производство на интегрални схеми изискват технология за епитаксиален растеж. Тъй като полупроводниците съдържат примеси от N-тип и P-тип, чрез различни видове комбинации, полупроводниковите устройства и интегралните схеми имат различни функции, които могат лесно да бъдат постигнати чрез използване на технология за епитаксиален растеж.
Методите на епитаксиалния растеж на силиций могат да бъдат разделени на епитаксията на фазата на парата, епитаксията на течната фаза и епитаксията на твърдата фаза. Понастоящем методът на растеж на отлагане на химически пари се използва широко в международен план, за да отговори на изискванията за целостта на кристалите, диверсификацията на структурата на устройството, простото и контролиращото устройство, производството на партиди, осигуряването на чистота и еднаквостта.
Парофазовата епитаксия отглежда отново единичен кристален слой върху единична кристална силициева пластина, запазвайки оригиналното наследство на решетката. Температурата на епитаксия на парната фаза е по-ниска, главно за да се гарантира качеството на интерфейса. Парофазната епитаксия не изисква допинг. По отношение на качеството епитаксията в парна фаза е добра, но бавна.
Оборудването, използвано за химическа парофазова епитаксия, обикновено се нарича епитаксиален растежен реактор. Обикновено се състои от четири части: система за контрол на парната фаза, електронна система за управление, тяло на реактора и изпускателна система.
Според структурата на реакционната камера има два вида системи за епитаксиален растеж на силиций: хоризонтални и вертикални. Хоризонталният тип се използва рядко, а вертикалният тип е разделен на плоски плочи и варели. Във вертикална епитаксиална пещ основата се върти непрекъснато по време на епитаксиален растеж, така че еднородността е добра и производственият обем е голям.
Корпусът на реактора е графитна основа с висока чистота с многоъгълен конусен варелен тип, който е специално обработен, окачен в кварцова камбана с висока чистота. Силиконовите пластини се поставят върху основата и се нагряват бързо и равномерно с инфрачервени лампи. Централната ос може да се върти, за да образува строго двойно запечатана топлоустойчива и взривозащитена структура.
Принципът на работа на оборудването е следният:
● Реакционният газ навлиза в реакционната камера от газовия вход в горната част на буркана, пръска се от шест кварцови дюзи, подредени в кръг, блокира се от кварцовата преграда и се движи надолу между основата и буркана, реагира при висока температура и се отлага и расте на повърхността на силиконовата пластина, а реакционният остатъчен газ се изхвърля на дъното.
● Принцип на разпределение на температурата 2061 Нагряване: Високочестот и висок ток преминава през индукционната намотка, за да създаде магнитно поле на вихъра. Основата е проводник, който е във магнитно поле на вихъра, генерира индуциран ток и токът загрява основата.
Епитаксиалният растеж на парата на парата осигурява специфична процесна среда за постигане на растежа на тънък слой от кристали, съответстващ на единичната кристална фаза върху единичен кристал, което прави основни препарати за функционализацията на еднократното потъване на кристала. Като специален процес кристалната структура на отглеждания тънък слой е продължение на единичния кристален субстрат и поддържа съответна връзка с кристалната ориентация на субстрата.
В развитието на науката и технологиите за полупроводници епитаксията в парна фаза изигра важна роля. Тази технология е широко използвана в промишленото производство на Si полупроводникови устройства и интегрални схеми.
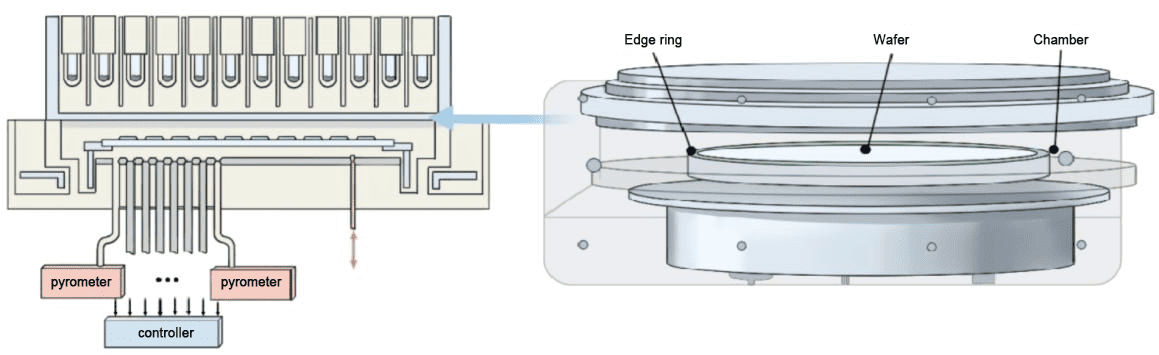
Метод за епитаксиален растеж в газова фаза
Газове, използвани в епитаксиално оборудване:
● Често използваните силиконови източници са SIH4, SIH2CL2, SIHCL3 и SICL4. Сред тях SIH2CL2 е газ при стайна температура, лесен за използване и има ниска температура на реакция. Това е източник на силиций, който постепенно се разширява през последните години. SIH4 също е газ. Характеристиките на силанова епитаксия са ниска температура на реакцията, без корозивен газ и могат да получат епитаксиален слой със стръмно разпределение на примесите.
● SiHCl3 и SiCl4 са течности при стайна температура. Температурата на епитаксиален растеж е висока, но скоростта на растеж е бърза, лесна за пречистване и безопасна за употреба, така че те са по-често срещани източници на силиций. SiCl4 се използва най-вече в ранните дни, а употребата на SiHCl3 и SiH2Cl2 постепенно се увеличава напоследък.
● Тъй като △ h на реакцията на намаляване на водорода на силициеви източници като SICL4 и реакцията на термично разлагане на SIH4 е положителна, тоест, повишаването на температурата е благоприятно за отлагането на силиций, реакторът трябва да се нагрява. Методите на нагряване включват главно високочестотно индукционно отопление и отопление на инфрачервено радиация. Обикновено пиедестал, изработен от графит с висока чист за поставяне на силиконов субстрат, се поставя в кварц или реакционна камера от неръждаема стомана. За да се гарантира качеството на силициевия епитаксиален слой, повърхността на графитния пиедестал се покрива с SIC или се отлага с поликристален силиконов филм.
Свързани производители:
● International: CVD Company Company на Съединените щати, GT Company на Съединените щати, Soitec Company of France, като компания на Франция, Proto Flex Company от Съединените щати, Kurt J. Lesker Company от Съединените щати, Applied Material Company на Съединените щати.
● Китай: 48 -ият институт на Китайската технологична група за електроника, Qingdao Sairuida, Hefei Kejing Materials Technology Co., Ltd.,VeTek Semiconductor Technology Co., LTD, Пекин Jinsheng Micronano, Jinan Liguan Electronic Technology Co., Ltd.
Основно приложение:
Системата за епитаксия на течната фаза се използва главно за епитаксиалния растеж на течната фаза на епитаксиалните филми в производствения процес на сложни полупроводникови устройства и е ключово оборудване за разработване и производство на оптоелектронни устройства.
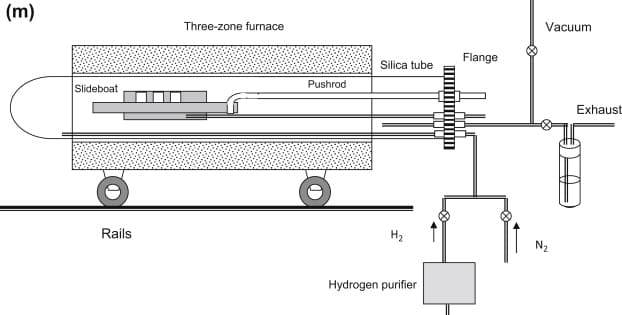
Технически характеристики:
● Висока степен на автоматизация. С изключение на зареждането и разтоварването, целият процес автоматично се завършва чрез индустриален компютър за компютър.
● Процесните операции могат да бъдат завършени от манипулатори.
● Точността на позициониране на движението на манипулатора е по-малка от 0,1 mm.
● Температурата на пещта е стабилна и повторяема. Точността на зоната с постоянна температура е по-добра от ±0,5 ℃. Скоростта на охлаждане може да се регулира в диапазона от 0,1~6℃/мин. Зоната с постоянна температура има добра плоскост и добра линейност на наклона по време на процеса на охлаждане.
● Перфектна функция за охлаждане.
● Изчерпателна и надеждна функция за защита.
● Висока надеждност на оборудването и добра повторяемост на процеса.
Vetek Semiconductor е професионален производител и доставчик на епитаксиално оборудване в Китай. Нашите основни епитаксиални продукти включватCVD SiC покритие барел възприемател, SiC покритие барел фиксатор, SIC покритие с графитен варел престол за EPI, CVD SiC покритие Wafer Epi Susceptor, Графитна въртяща се поддръжка, и т.н. VeTek Semiconductor отдавна се ангажира да предоставя усъвършенствани технологии и продуктови решения за епитаксиална обработка на полупроводници и поддържа персонализирани продуктови услуги. Искрено се надяваме да станем ваш дългосрочен партньор в Китай.
Ако имате някакви запитвания или се нуждаете от допълнителни подробности, моля, не се колебайте да се свържете с нас.
Моб/WhatsAPP: +86-180 6922 0752
Имейл: anny@veteksemi.com



+86-579-87223657


Wangda Road, Ziyang Street, Wuyi County, Jinhua City, Zhejiang Province, Китай
Авторско право © 2024 WuYi TianYao Advanced Material Tech.Co., Ltd. Всички права запазени.
Links | Sitemap | RSS | XML | Политика за поверителност |
