QR код

Продукти
Свържете се с нас


факс
+86-579-87223657

Електронна поща

Адрес
Wangda Road, Ziyang Street, Wuyi County, Jinhua City, Zhejiang Province, Китай
В производството на полупроводници,Химическа механична планаризация (CMP)Процесът е основният етап за постигане на планаризация на повърхността на вафла, директно определящ успеха или неуспеха на следващите стъпки на литографията. Като критичен консуматив в CMP, производителността на полиращата суспензия е крайният фактор за контролиране на скоростта на отстраняване (RR), минимизиране на дефектите и подобряване на общия добив.
Това ръководство предоставя систематичен анализ на техническата рамка на CMP суспензията и изследва как да се поддържа стабилността на процеса в сложни производствени среди, за да се постигне намаляване на разходите и повишаване на ефективността.

I. Типичен състав на CMP суспензия
Типичната CMP суспензия е синергичен продукт на химическо действие и физична механична сила, състоящ се от следните основни компоненти:
Абразиви: Осигуряват възможности за механично отстраняване. Често срещаните видове включват силициев диоксид, церий и алуминий с наноразмери.
Окислители: Увеличават скоростта на химичните реакции чрез окисляване на металната повърхност; обичайните примери включват H2O2 или железни соли.
Хелатиращи агенти: образуват комплекси с метални йони за улесняване на разтварянето.
Инхибитори на корозията: Подобряват селективността на материала чрез потискане на корозията в нецелевите зони.
Добавки: Включете регулатори на pH и диспергатори, използвани за поддържане на реакционния прозорец и стабилността на системата.
Химическото и физическото поведение на суспензията трябва да бъде точно съобразено с характеристиките на целевия материал; в противен случай ще се появят дефекти като драскотини, люспи и корозия.①
II. Системи за суспензия за различни материали
Тъй като свойствата на материала на различни вафлифилмовите слоеве се различават значително, суспензиите трябва да бъдат персонализирани и насочени:
|
Целеви тип материал |
Общ тип суспензия |
Ключови характеристики |
|
Силициев диоксид(SiO₂) |
Колоидна суспензия от силициев диоксид |
Умерен процент на отстраняване с висока селективност |
|
Мед (Cu) |
Композитна система с окислители/хелатори/инхибитори |
Податливи на корозия; главно задвижван от химичен контрол |
|
Волфрам (W) |
Комбинация желязна сол + Абразив |
Изисква потискане на корозията и изглаждането; тесен прозорец на процеса |
|
Тантал/танталов нитрид (Ta/TaN) |
Суспензия с висока селективност, често споделяна с Cu |
Обикновено в комбинация с медни процеси; изключително високи изисквания за контрол на дефектите |
|
Ниско-k материали |
Система за химическо полиране без абразиви |
Предотвратява микропукнатини; висок риск от счупване на филма |
III. Ключови показатели за ефективност
Когато се оценява потенциалът за повишаване на ефективността, следните технически индикатори са жизненоважни:
Скорост на отстраняване (RR): Дебелината на материала, отстранен за единица време (nm/min), което пряко влияе върху производителността на фабриката.
Селективност: Съотношението на степента на отстраняване на целевия материал към тази на съседните материали; по-високата селективност защитава по-добре нецелевите слоеве.
Неравномерност в рамките на пластината (WIWNU): Измерва последователността на планаризацията по повърхността на пластината.
Дефектност: Включва критични показатели за намаляване на добива, като драскотини и остатъци от микрочастици. Стабилност на суспензията: Способността на суспензията да устои на набраздяване, агломерация или утаяване по време на съхранение и употреба.
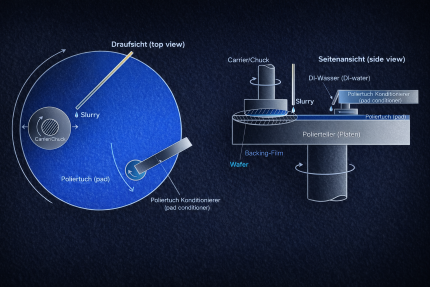
IV. Най-добри практики в индустрията за подобряване на стабилността на процеса
За постигане на дългосрочно „намаляване на разходите и повишаване на ефективността“, водещите полупроводникови предприятия се фокусират върху следните практики за управление на стабилността:
Прецизен баланс на химически и механични сили: Чрез фино регулиране на съотношението на абразивите към химическите компоненти, реакционното равновесие се поддържа на молекулярно ниво, намалявайки дефектите при изглаждане при източника.
Стабилност на флуида и управление на филтрацията: Строг контрол на флуктуациите на рН в системата за циркулация на суспензията, комбиниран с високоефективна технология за филтриране, предотвратява летливостта на надраскване, причинена от агломерация на частици.
Персонализирано съвпадение на процеса: Разработени са специфични суспензии за различни физически твърдости (напр. SiC с висока твърдост или крехки материали с ниско k) за максимизиране на прозореца на процеса.
Стандарти за мониторинг на последователност: Създаването на стриктна стратегия за контрол на партидите гарантира, че ключови показатели като RR и WIWNU остават последователни по време на масовото производство.
Aавтор:Сера-Лий
Справка:
①Избор на тор от CMP: гледна точка на материалите – AZoM
②Общ преглед на химията на суспензията за химическа механична планаризация – Entegris



+86-579-87223657


Wangda Road, Ziyang Street, Wuyi County, Jinhua City, Zhejiang Province, Китай
Авторско право © 2024 WuYi TianYao Advanced Material Tech.Co., Ltd. Всички права запазени.
Links | Sitemap | RSS | XML | Политика за поверителност |
