QR код

Продукти
Свържете се с нас


факс
+86-579-87223657

Електронна поща

Адрес
Wangda Road, Ziyang Street, Wuyi County, Jinhua City, Zhejiang Province, Китай
Силиконова епитаксияе основен основен процес в съвременното производство на полупроводници. Отнася се до процеса на отглеждане на един или повече слоеве от монокристален силициев тънък филм със специфична кристална структура, дебелина, концентрация на допинг и тип върху прецизно полиран монокристален силициев субстрат. Този нараснал филм се нарича епитаксиален слой (епитаксиален слой или Epi слой), а силиконова пластина с епитаксиален слой се нарича епитаксиална силициева пластина. Неговата основна характеристика е, че новоотгледаният епитаксиален силициев слой е продължение на решетъчната структура на субстрата в кристалографията, поддържайки същата кристална ориентация като субстрата, образувайки перфектна монокристална структура. Това позволява на епитаксиалния слой да има прецизно проектирани електрически свойства, които са различни от тези на субстрата, като по този начин осигурява основа за производството на високопроизводителни полупроводникови устройства.
![]()
Вертикален епитаксиален фиксатор за силиконова епитаксия
1) Определение: Силициевата епитаксия е технология, която отлага силициеви атоми върху монокристален силициев субстрат чрез химични или физични методи и ги подрежда според структурата на решетката на субстрата, за да се получи нов монокристален силициев тънък филм.
2) Съвпадение на решетката: Основната характеристика е подредеността на епитаксиалния растеж. Отложените силициеви атоми не са произволно подредени, а са подредени според кристалната ориентация на субстрата под ръководството на "шаблона", осигурен от атомите на повърхността на субстрата, постигайки прецизна репликация на атомно ниво. Това гарантира, че епитаксиалният слой е висококачествен монокристал, а не поликристален или аморфен.
3) Контролируемост: Процесът на силициева епитаксия позволява прецизен контрол на дебелината на растежния слой (от нанометри до микрометри), типа допинг (N-тип или P-тип) и концентрацията на допинг. Това позволява на една и съща силиконова пластина да се формират области с различни електрически свойства, което е ключът към производството на сложни интегрални схеми.
4) Характеристики на интерфейса: Формира се интерфейс между епитаксиалния слой и субстрата. В идеалния случай този интерфейс е атомно плосък и без замърсяване. Качеството на интерфейса обаче е от решаващо значение за работата на епитаксиалния слой и всякакви дефекти или замърсяване могат да повлияят на крайната работа на устройството.
Епитаксиалният растеж на силиций зависи главно от осигуряването на правилната енергия и среда за силициевите атоми да мигрират по повърхността на субстрата и да намерят най-ниската енергийна позиция на решетката за комбиниране. Най-често използваната технология в момента е химическо отлагане на пари (CVD).
Химично отлагане на пари (CVD): Това е основният метод за постигане на силициева епитаксия. Основните му принципи са:
● Прекурсорен транспорт: Газ, съдържащ силициев елемент (прекурсор), като силан (SiH4), дихлоросилан (SiH2Cl2) или трихлоросилан (SiHCl3), и добавка газ (като фосфин PH3 за N-тип допиране и диборан B2H6 за P-тип допиране) се смесват в точни пропорции и преминават във високотемпературна реакционна камера.
● Повърхностна реакция: При високи температури (обикновено между 900°C и 1200°C) тези газове претърпяват химично разлагане или реакция на повърхността на нагрятия силициев субстрат. Например SiH4→Si(твърд)+2H2(газ).
● Повърхностна миграция и нуклеация: Силициевите атоми, произведени от разлагането, се адсорбират към повърхността на субстрата и мигрират по повърхността, като в крайна сметка намират правилното място на решетката, за да се комбинират и да започнат да образуват нова единичнакристален слой. Качеството на силиция за епитаксиален растеж зависи до голяма степен от контрола на тази стъпка.
● Слоест растеж: Новоотложеният атомен слой непрекъснато повтаря структурата на решетката на субстрата, расте слой по слой и образува епитаксиален силициев слой с определена дебелина.
Ключови параметри на процеса: Качеството на процеса на силициева епитаксия е строго контролирано и ключовите параметри включват:
● температура: влияе върху скоростта на реакцията, подвижността на повърхността и образуването на дефекти.
● налягане: засяга транспорта на газ и реакционния път.
● Газов поток и съотношение: определя скоростта на растеж и концентрацията на допинг.
● Чистота на повърхността на основата: Всеки замърсител може да бъде източник на дефекти.
● Други технологии: Въпреки че CVD е мейнстрийм, технологии като Molecular Beam Epitaxy (MBE) също могат да се използват за силициева епитаксия, особено в R&D или специални приложения, които изискват изключително високо прецизен контрол.MBE директно изпарява източници на силиций в среда с ултрависок вакуум и атомни или молекулярни лъчи се проектират директно върху субстрата за растеж.
Технологията за силициева епитаксия значително разшири обхвата на приложение на силициевите материали и е незаменима част от производството на много усъвършенствани полупроводникови устройства.
● CMOS технология: Във високопроизводителни логически чипове (като CPU и GPU), епитаксиален силициев слой с ниско добавка (P− или N−) често се отглежда върху силно легирана (P+ или N+) подложка. Тази структура на епитаксиална силициева пластина може ефективно да потисне ефекта на затваряне (Latch-up), да подобри надеждността на устройството и да поддържа ниското съпротивление на субстрата, което е благоприятно за токова проводимост и разсейване на топлината.
● Биполярни транзистори (BJT) и BiCMOS: В тези устройства силициевата епитаксия се използва за точно конструиране на структури като основата или колекторната област, а усилването, скоростта и други характеристики на транзистора се оптимизират чрез контролиране на концентрацията на допинг и дебелината на епитаксиалния слой.
● Сензор за изображение (CIS): В някои приложения на сензори за изображения епитаксиалните силициеви пластини могат да подобрят електрическата изолация на пикселите, да намалят смущенията и да оптимизират ефективността на фотоелектричното преобразуване. Епитаксиалният слой осигурява по-чиста и по-малко дефектна активна зона.
● Разширени процесни възли: Тъй като размерът на устройството продължава да намалява, изискванията за свойствата на материала стават все по-високи и по-високи. Технологията за силициева епитаксия, включително селективен епитаксиален растеж (SEG), се използва за отглеждане на епитаксиални слоеве от напрегнат силиций или силициев германий (SiGe) в специфични области за подобряване на мобилността на носителя и по този начин увеличаване на скоростта на транзисторите.
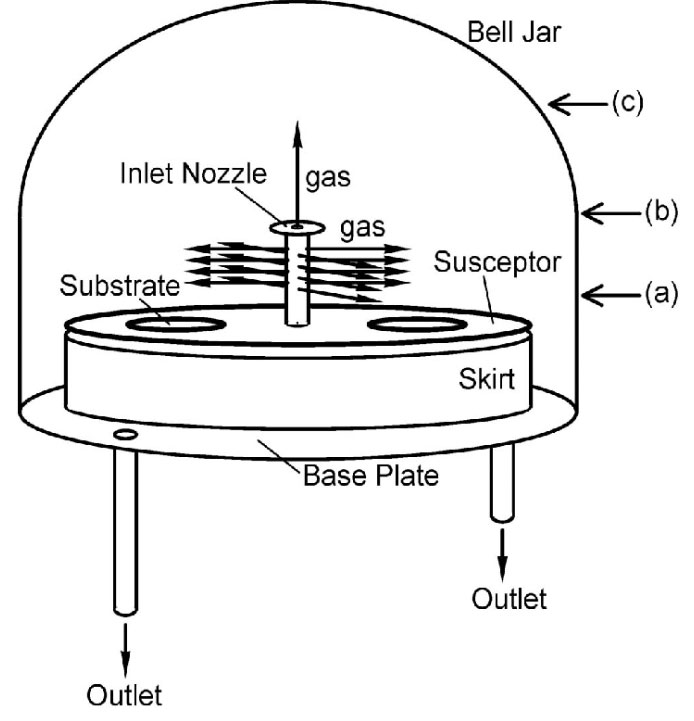
Хоризонтален епитаксиален фиксатор за силиконова епитаксия
Въпреки че технологията за силициева епитаксия е зряла и широко използвана, все още има някои предизвикателства и проблеми в процеса на епитаксиален растеж на силиций:
● Контрол на дефектите: По време на епитаксиален растеж могат да се генерират различни кристални дефекти, като грешки при подреждане, дислокации, линии на приплъзване и др. Тези дефекти могат сериозно да повлияят на електрическите характеристики, надеждността и производителността на устройството. Контролирането на дефектите изисква изключително чиста среда, оптимизирани параметри на процеса и висококачествени субстрати.
● Еднородност: Постигането на перфектна еднородност на дебелината на епитаксиалния слой и концентрацията на допинг върху силициеви пластини с голям размер (като 300 mm) е продължаващо предизвикателство. Нееднородността може да доведе до разлики в производителността на устройството на една и съща пластина.
● Автодопинг: По време на процеса на епитаксиален растеж добавките с висока концентрация в субстрата могат да навлязат в нарастващия епитаксиален слой чрез дифузия в газова фаза или дифузия в твърдо състояние, причинявайки концентрацията на допинг на епитаксиалния слой да се отклони от очакваната стойност, особено близо до интерфейса между епитаксиалния слой и субстрата. Това е един от проблемите, които трябва да бъдат разгледани в процеса на силициева епитаксия.
● Морфология на повърхността: Повърхността на епитаксиалния слой трябва да остане много плоска и всякакви грапавини или повърхностни дефекти (като мъгла) ще повлияят на последващи процеси като литография.
● цена: В сравнение с обикновените полирани силициеви пластини, производството на епитаксиални силициеви пластини добавя допълнителни стъпки на процеса и инвестиции в оборудване, което води до по-високи разходи.
● Предизвикателства на селективната епитаксия: В напредналите процеси селективният епитаксиален растеж (растеж само в определени области) поставя по-високи изисквания към контрола на процеса, като селективност на скоростта на растеж, контрол на страничния свръхрастеж и т.н.
Като ключова технология за подготовка на полупроводников материал, основната характеристика насиликонова епитаксияе способността за точно отглеждане на висококачествени монокристални епитаксиални силициеви слоеве със специфични електрически и физични свойства върху монокристални силициеви субстрати. Чрез прецизен контрол на параметри като температура, налягане и въздушен поток в процеса на силициева епитаксия, дебелината на слоя и разпределението на допинга могат да бъдат персонализирани, за да отговорят на нуждите на различни полупроводникови приложения като CMOS, захранващи устройства и сензори.
Въпреки че епитаксиалният растеж на силиций е изправен пред предизвикателства като контрол на дефектите, еднородност, самодопинг и цена, с непрекъснатия напредък на технологията, силициевата епитаксия все още е една от основните движещи сили за насърчаване на подобряване на производителността и функционални иновации на полупроводникови устройства и нейната позиция в производството на епитаксиални силициеви пластини е незаменима.



+86-579-87223657


Wangda Road, Ziyang Street, Wuyi County, Jinhua City, Zhejiang Province, Китай
Авторско право © 2024 WuYi TianYao Advanced Material Tech.Co., Ltd. Всички права запазени.
Links | Sitemap | RSS | XML | Политика за поверителност |
