QR код

Продукти
Свържете се с нас


факс
+86-579-87223657

Електронна поща

Адрес
Wangda Road, Ziyang Street, Wuyi County, Jinhua City, Zhejiang Province, Китай
Силиконовите карбидни субстрати имат много дефекти и не могат да бъдат обработвани директно. Върху тях трябва да се отглежда специфичен единичен кристален тънък филм чрез епитаксиален процес, за да се направят чип вафли. Този тънък филм е епитаксиалният слой. Почти всички устройства с силициев карбид се реализират върху епитаксиални материали. Висококачествените силиконови карбидни хомогенни епитаксиални материали са основата за разработването на устройства за силициев карбид. Производителността на епитаксиалните материали директно определя реализацията на работата на устройствата на силициевия карбид.
Устройствата за силициев карбид с висок ток и висока надеждност са предложили по-строги изисквания за морфологията на повърхността, плътността на дефектите, допинг и равномерност на дебелината на епитаксиалните материали. С голям размер, ниска плътност и висока единностСиликонов карбид Епитаксиясе превърна в ключ към развитието на индустрията на силициевия карбид.
Подготовката на висококачественоСиликонов карбид ЕпитаксияИзисква усъвършенствани процеси и оборудване. Най -широко използваният метод на растеж на епитаксиалния растеж на силициев карбид е химическото отлагане на пари (CVD), който има предимствата на прецизния контрол на дебелината на епитаксиалния филм и концентрацията на допинг, по -малко дефекти, умерен темп на растеж и автоматичен контрол на процеса. Това е надеждна технология, която успешно е комерсиализирана.
Silicon Carbide CVD Epitaxy обикновено използва гореща стена или топла стена CVD оборудване, което гарантира продължаването на епитаксиалния слой 4h кристал sic при по-високи температурни условия на растеж (1500-1700 ℃). След години на развитие, CVD с гореща стена или топла стена могат да бъдат разделени на хоризонтални хоризонтални структурни реактори и вертикални вертикални структурни реактори според връзката между посоката на потока на входящия газ и повърхността на субстрата.
Качеството на епитаксиалната пещ на силициевия карбид главно има три показателя. Първият е епитаксиалният растеж, включително равномерност на дебелината, униформа на допинг, скорост на дефекти и темп на растеж; Втората е температурната характеристика на самото оборудване, включително скорост на отопление/охлаждане, максимална температура, температурна равномерност; и накрая разходите за самото оборудване, включително единична цена и производствен капацитет.
Хоризонтално CVD с гореща стена, топло стена планетарна ССЗ и квази-гореща стена вертикална ССЗ са основните решения за епитаксиално оборудване на епитаксиалното оборудване, които са приложени в търговската мрежа на този етап. Трите техническо оборудване също имат свои характеристики и могат да бъдат избрани според нуждите. Диаграмата на структурата е показана на фигурата по -долу:

Хоризонталната CVD система за гореща стена обикновено е система за растеж с голям размер с голям размер, задвижвана от въздушна флотация и въртене. Лесно е да се постигнат добри показатели в Wafer. Представителният модел е PE1O6 на LPE Company в Италия. Тази машина може да реализира автоматично зареждане и разтоварване на вафли при 900 ℃. Основните характеристики са високия темп на растеж, кратък епитаксиален цикъл, добра консистенция в рамките и между пещите и др. Той има най -висок пазарен дял в Китай.

According to LPE official reports, combined with the usage of major users, the 100-150mm (4-6 inches) 4H-SiC epitaxial wafer products with a thickness of less than 30μm produced by the Pe1O6 epitaxial furnace can stably achieve the following indicators: intra-wafer epitaxial thickness non-uniformity ≤2%, intra-wafer doping concentration non-uniformity ≤5%, surface defect density ≤1cm-2, площ без дефекти (2 мм × 2 мм единична клетка) ≥90%.
Местните компании като JSG, CETC 48, Naura и NASO са разработили епитаксиално оборудване на монолитен силиций карбид с подобни функции и са постигнали мащабни пратки. Например, през февруари 2023 г., JSG пусна 6-инчов двупосочен епитаксиално оборудване с двойна вафла. The equipment uses the upper and lower layers of the upper and lower layers of the graphite parts of the reaction chamber to grow two epitaxial wafers in a single furnace, and the upper and lower process gases can be separately regulated, with a temperature difference of ≤5°C, which effectively makes up for the disadvantage of insufficient production capacity of monolithic horizontal epitaxial furnaces.The key spare part isSic покритие полумесени части. Ние доставяме 6 -инчови и 8 инчови половин местни части на потребителите.

Планетарна CVD система с топло стена, с планетарна подредба на основата, се характеризира с растежа на множество вафли в една пещ и висока ефективност на изхода. Представителни модели са AIXG5WWC (8x150mm) и G10-SIC (9 × 150 мм или 6 × 200 мм) Епитаксиално оборудване на Aixtron на Германия.
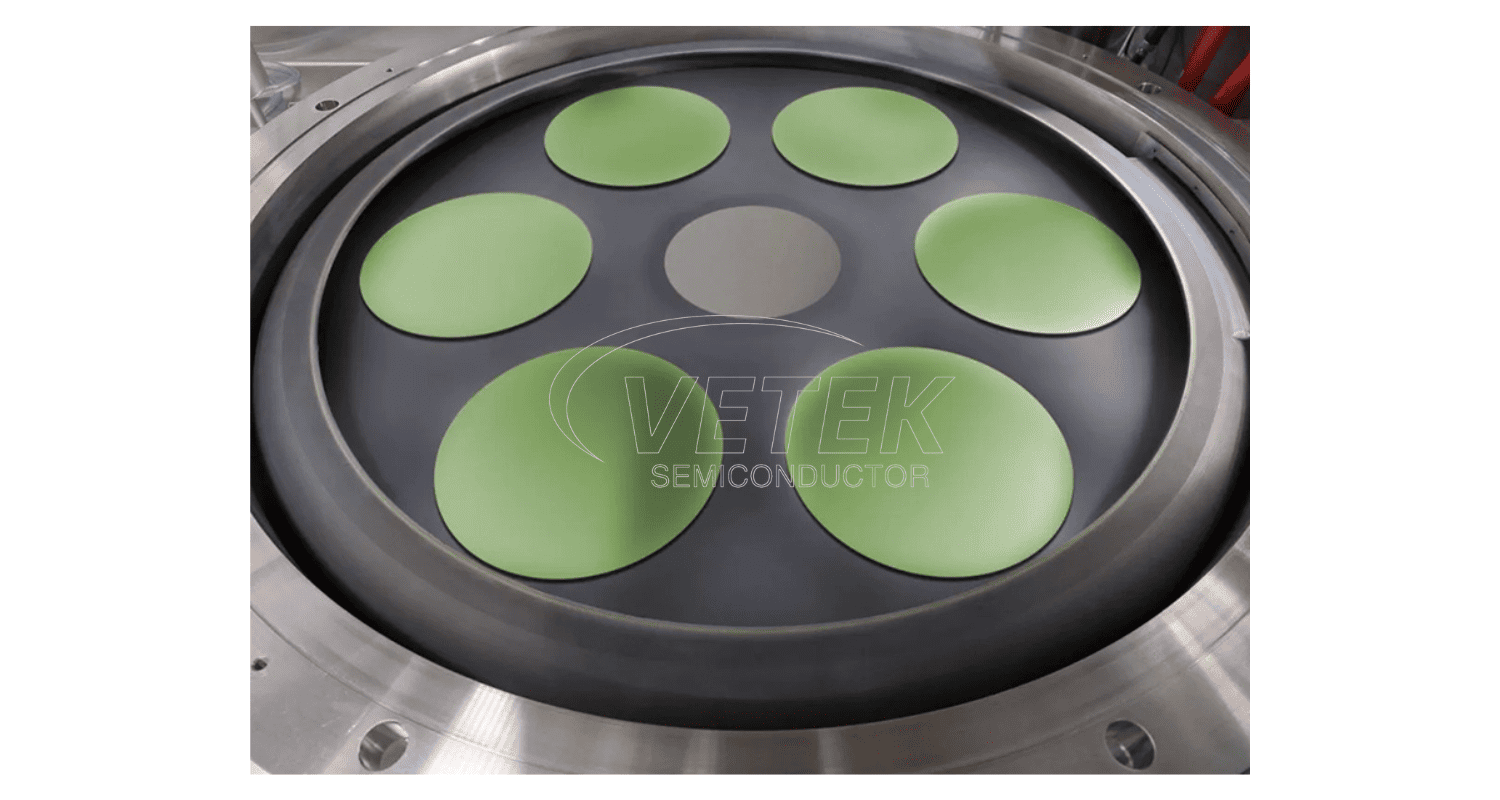
Според официалния доклад на Aixtron, 6-инчовите епитаксиални вафли с 4H-SIC с дебелина 10 μm, произведени от епитаксиалната пещ G10, могат стабилно да постигнат следните показатели: отклонение на епитаксията на е епитаксиална дебелина ± 2,5%, вътрешно-вафровата дебелина на неравномерността на 2%, междувесната концентрация на концентриране на 2%, не-1%, разсейване на 2%, разрушаване на допиращата концентрация на ± 5%, отклонение от 2%, междувес Концентрация, неедностичност <2%.
Досега този тип модел рядко се използва от домашните потребители, а данните за производството на партиди са недостатъчни, което до известна степен ограничава неговото инженерно приложение. В допълнение, поради високите технически бариери на епитаксиалните пещи с много вафли по отношение на температурното поле и контрола на полето на потока, разработването на подобно битово оборудване все още е в етапа на изследване и разработки и няма алтернативен модел. В междувременно можем да осигурим планетарен сумптор на Aixtron като 6 инчов и 8 инча с Tac покритие или SIC покритие.
Квази-горещата вертикална CVD система се върти главно с висока скорост чрез външна механична помощ. Характеристиката му е, че дебелината на вискозния слой ефективно се намалява от по -ниско налягане на реакционната камера, като по този начин увеличава скоростта на растеж на епитаксиалния растеж. В същото време реакционната му камера няма горна стена, върху която могат да се отлагат SIC частици, и не е лесно да се получат падащи предмети. Той има присъщо предимство в контрола на дефектите. Представителните модели са епитаксиалната пещи с една вафла Epirevos6 и Epirevos8 на японския Nuflare.
Според Nuflare, скоростта на растеж на устройството Epirevos6 може да достигне повече от 50 μm/h, а плътността на повърхностния дефект на епитаксиалната вафла може да бъде контролирана под 0,1 cm -²; По отношение на контрола на равномерността, инженерът на Nuflare Yoshiaki Daigo отчете резултатите от вътрешността на вътрешната вафла на 6-инчов епитаксиална вафла с дебелина 10 μm, отглеждайки се с епиревос6, а вътрешността на вътрешната ваферГорният графитен цилиндър.
Понастоящем производителите на домашно оборудване като основно трето поколение и JSG са проектирали и стартирали епитаксиално оборудване с подобни функции, но те не са били използвани в голям мащаб.
Като цяло трите типа оборудване имат свои характеристики и заемат определен пазарен дял в различни нужди от приложението:
Хоризонталната структура на CVD с гореща стена разполага с ултра бърз темп на растеж, качество и еднообразие, проста работа и поддръжка на оборудването и зрели мащабни производствени приложения. Поради типа с една вара и честата поддръжка, ефективността на производството е ниска; Планетарната стенна CVD с топла стена обикновено приема 6 (парче) × 100 мм (4 инча) или 8 (парче) × 150 мм (6 инча) структура, която значително подобрява производствената ефективност на оборудването по отношение на производствения капацитет, но е трудно да се контролира консистенцията на множество части, а добивът на производството все още е най -големият проблем; Квази-горещата стена вертикална CVD има сложна структура, а качественият дефект на дефектите на производството на епитаксиални вафли е отличен, което изисква изключително богато поддръжка и използване на оборудването.
Бърз темп на растеж
просто структура на оборудването и
удобна поддръжка
Голям производствен капацитет
Висока ефективност на производството
Добър контрол на дефектите на продукта
Дълга реакционна камера
цикъл на поддръжка
Сложна структура
Трудно за контрол
Консистенция на продукта
Сложна структура на оборудването,
трудна поддръжка
Представител
оборудване
производители
Хоризонтална стента за гореща стена
Планетарна стена на топла стена cwd
Квази-горещ стенен вертикален CTD
Предимства
Недостатъци
Кратък цикъл на поддръжка
Италия LPE, Япония Тел
Германия Aixtron
Япония Nuflare
С непрекъснатото развитие на индустрията, тези три вида оборудване ще бъдат итеративно оптимизирани и надградени по отношение на структурата, а конфигурацията на оборудването ще стане все по -съвършена, играейки важна роля за съпоставяне на спецификациите на епитаксиалните вафли с различни дебелини и изисквания за дефект.



+86-579-87223657


Wangda Road, Ziyang Street, Wuyi County, Jinhua City, Zhejiang Province, Китай
Авторско право © 2024 WuYi TianYao Advanced Material Tech.Co., Ltd. Всички права запазени.
Links | Sitemap | RSS | XML | Политика за поверителност |
